FIB後処理用イオンミリング装置 ナノミル Model1040

FIB後処理用イオンミリング装置 ナノミル Model1040
仕様
イオン源:- 静電レンズと組み合わせたフィラメントベースのイオン源
- ビーム径:約1μm
- ビームエネルギー:50eV~2.0keV
- ビーム電流密度:最大8mA/cm2
- ファラデーカップにより1pA~2,000pAのビーム電流を測定
- ロードロック機構により10秒以内に試料の交換が可能
- ミリング角度:0°~±10°
- 液体窒素誘導冷却
- システム冷却温度:最低-175℃
- システム冷却時間:20分未満
- 試料冷却時間:5分未満
- 冷却継続時間:最大6時間
- SED(二次電子検出器)を使用したイメージング
- 視野3mm×3mm
- 試料を観察しながらミリング位置をピンポイントで設定
- 重量:230.5kg
- 寸法:幅991mm×高さ1,474mm×奥行き788mm
- 電圧:100V, 50/60Hz
- 消費電力:1,000W
用途
ナノミルModel1040は、高度なTEMイメージングや解析に必要とされる極薄かつ高品質の試料を作製するためのイオンミリング装置です。独自に開発されたイオン源は、50eV~という低イオンエネルギーを生成し、ビーム径も僅か1μmと小さいため、再付着(リデポジッション)を起こさずに、アモルファス層や注入層の除去を行えます。
ナノミルModel1040の主な用途は、集束イオンビーム(FIB)加工後の処理です。FIBはTEM試料を作製する上で極めて有効な手法ですが、表層のアモルファス化やガリウムイオンの注入がしばしば発生します。このようなダメージ層は、厚さ10nm~30nmに達することもあります。ナノミルModel1040は、このようなダメージ層の除去に最適な装置です。
特徴
小さく絞られた超低エネルギーイオンビーム:ナノミルのイオン源は、フィラメントを使用したイオン化チャンバーと静電レンズを特徴としています。このイオン源は、超低エネルギーかつ細いビーム径を実現するために独自に開発されたものです。
不活性ガス(アルゴンガス)を利用し、さまざまな作動距離に対して50eVから2kVの範囲のイオンビームを出力します。実用的な電流密度を有しており、わずか20分程度のイオンミリングで、アモルファスのない理想的なサンプルの作製が可能です。イオンビームは直径2ミクロン程度に集束しているため、スパッタリングされた材料の再付着(リデポジッション)を最小限に抑えられます。

良質のTEM試料を作製するには、イオンビームを試料に対して適切な位置に照射する必要があります。特にFIB試料の場合、サポートグリッド上の試料の大きさが僅か10μm2程度になることもあり、ビーム位置の正確な位置調整が必須です。
ナノミルModel1040は、画像を取得するためにEverhart-Thornley二次電子検出器(SED)を装備しています。試料に対してイオンビームを走査すると、放出された二次電子がSEDで検出され、試料の画像がWindows上にリアルタイムで表示されます。走査スピードは3段階で変更可能ですので、速度重視、画質重視など場面に応じたモードの選択が行えます。
適用例
シリコンの透過電子顕微鏡(TEM)画像:

シリコン[110]面の高分解能TEM画像(ナノミル使用前)
Ga 注入と表面のアモルファス化が位相コントラストに影響を与えている

シリコン[110]面の高分解能TEM画像(ナノミル使用後)
Ga 注入とアモルファス化の影響を受けた層がナノミルによって除去され、位相コントラストが改善している

収差補正済みの高分解能TEM画像(ナノミル使用後)
Ga 注入層とアモルファス層が除去され、シリコン原子構造(ダンベル)が明確に観察出来る
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士
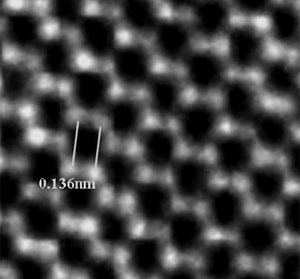
左写真の拡大画像
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士

上記シリコン格子のFFT画像
Ga 注入層とアモルファス層が除去され、試料の規則性が示されている
画像提供:オックスフォード大学Angus Kirkland教授およびCrispin Hetherington博士
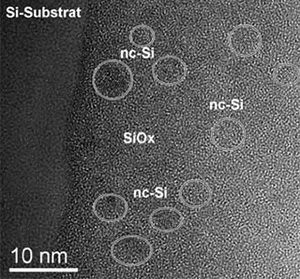
アモルファスSiOx基材に埋め込まれたシリコン量子ドット
サイズとビーム感度の関係で、これらの量子ドットはFIBのみで作製された薄片では見えなかった
試料提供:RWTHアーヘン大学およびエルンストルシュカセンター(ユーリヒ研究センター)J. Mayer、A.Dimyati

アモルファスSiOx基材に埋め込まれたシリコン量子ドット
サイズとビーム感度の関係で、これらの量子ドットはFIBのみで作製された薄片では見えなかった
試料提供:RWTHアーヘン大学およびエルンストルシュカセンター(ユーリヒ研究センター)J. Mayer、A.Dimyati
ニッケルベース超合金の透過電子顕微鏡(TEM)画像:
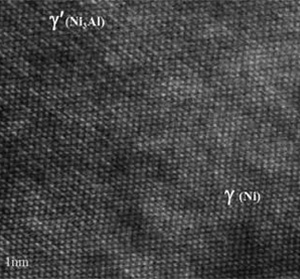
STEM(収差補正なし)によるZ-コントラスト(ナノミル未使用)
従来型のイオンミリングにより処理されたニッケルベース超合金René 88DT
試料提供:オハイオ州立大学Hamish Fraser教授

STEM(収差補正)によるZ-コントラスト(ナノミル使用後)
ナノミルを用いて500eVのArイオンミリングを実行。規則的に整列したニッケルベース超合金から、表面のダメ―ジ層が除去されていることが分かる。僅かな格子のミスマッチによるコヒーレントな境界が明らかにされている。
試料提供:オハイオ州立大学Hamish Fraser教授

EFTEM画像(ナノミル未使用)
30kVのFIBで作製したニッケルベース超合金René 88DT
試料提供:オハイオ州立大学Hamish Fraser教授
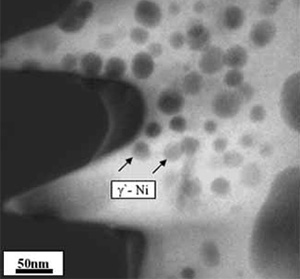
EFTEM画像(ナノミル使用後)
2000eVのナノミリングプロセスにより、相が明確になっている
試料提供:オハイオ州立大学Hamish Fraser教授
チタン合金の透過電子顕微鏡(TEM)画像:
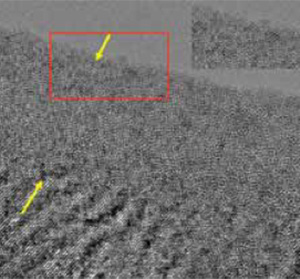
チタン合金の高分解能TEM画像(ナノミル未使用)
従来型のイオンミリングで作製された試料では10nm~12nmのアモルファス層が出来ている
試料提供:オハイオ州立大学Hamish Fraser教授
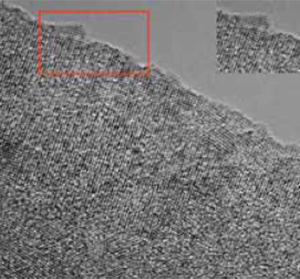
チタン合金の高分解能TEM画像(ナノミル使用後)
500eVのナノミリングプロセスにより、格子縞が見えるようになっている
試料提供:オハイオ州立大学Hamish Fraser教授
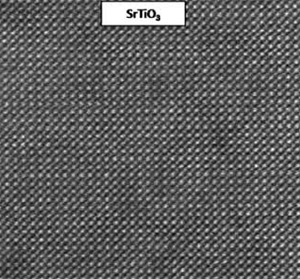
STEM(収差補正)によるHAADF像(ナノミル未使用)
5keVのFIBで作製したSrTiO3の<100>面
試料提供:オハイオ州立大学Hamish Fraser教授

STEM(収差補正)によるHAADF像(ナノミル使用後)
500eVのナノミリングプロセスにより、TiとSrからなる結晶格子が明確になっている
試料提供:オハイオ州立大学Hamish Fraser教授
